Patents
Literature
Hiro is an intelligent assistant for R&D personnel, combined with Patent DNA, to facilitate innovative research.
7 results about "Etching rate" patented technology
Efficacy Topic
Property
Owner
Technical Advancement
Application Domain
Technology Topic
Technology Field Word
Patent Country/Region
Patent Type
Patent Status
Application Year
Inventor
In a simple sense, etch rate is rate of the peeling off (removing) a compound or changing it into its elemental form from a surface either by some physical or chemical method.
Method and apparatus for buried word line formation
ActiveUS20120039104A1Solid-state devicesSemiconductor/solid-state device manufacturingEtching rateIntegrated circuit
Owner:MICRON TECH INC
Field effect transistor and method for manufacturing the same
ActiveUS20070099368A1Different etch rateTransistorSemiconductor/solid-state device manufacturingParasitic capacitanceField-effect transistor
Owner:ELECTRONICS & TELECOMM RES INST
Flexible semiconductor composite film and preparation method thereof
Owner:SHANGHAI INST OF MICROSYSTEM & INFORMATION TECH CHINESE ACAD OF SCI
Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method
InactiveCN104862702ADislocation display validEtching is effective for dislocation displayPolycrystalline material growthAfter-treatment detailsWater bathsWafering
Owner:INST OF SEMICONDUCTORS - CHINESE ACAD OF SCI
Methods and apparatus for the optimization of photo resist etching in a plasma processing system
InactiveUS6949469B1Minimize the differenceSemiconductor/solid-state device manufacturingResistFluorine containing
In a plasma processing system, a method of minimizing the differences in an etch rate of a photo resist material in different regions of a substrate is disclosed. The method includes introducing the substrate having in sequential order thereon, an underlying layer and the photo-resist layer. The method also includes flowing the etchant gas mixture into a plasma reactor of the plasma processing system, the etchant gas mixture comprising a flow of a fluorine containing gas between about 0.1% and about 10% of the etchant gas mixture. The method further includes striking a plasma from the gas mixture; etching the photo-resist layer with the plasma; and, removing the substrate from the plasma reactor.
Owner:LAM RES CORP
Formation method of semiconductor structure
PendingCN114551333AReduce difficultyImprove process controlSolid-state devicesSemiconductor/solid-state device manufacturingCrystallographySemiconductor structure
Owner:SEMICON MFG INT (SHANGHAI) CORP +1
Semiconductor structure and preparation method thereof, three-dimensional memory and storage system
PendingCN114551457AInhibit migrationImprove stabilitySolid-state devicesRead-only memoriesGate dielectricSemiconductor structure
Owner:YANGTZE MEMORY TECH CO LTD
Who we serve
- R&D Engineer
- R&D Manager
- IP Professional
Why Eureka
- Industry Leading Data Capabilities
- Powerful AI technology
- Patent DNA Extraction
Social media
Try Eureka
Browse by: Latest US Patents, China's latest patents, Technical Efficacy Thesaurus, Application Domain, Technology Topic.
© 2024 PatSnap. All rights reserved.Legal|Privacy policy|Modern Slavery Act Transparency Statement|Sitemap
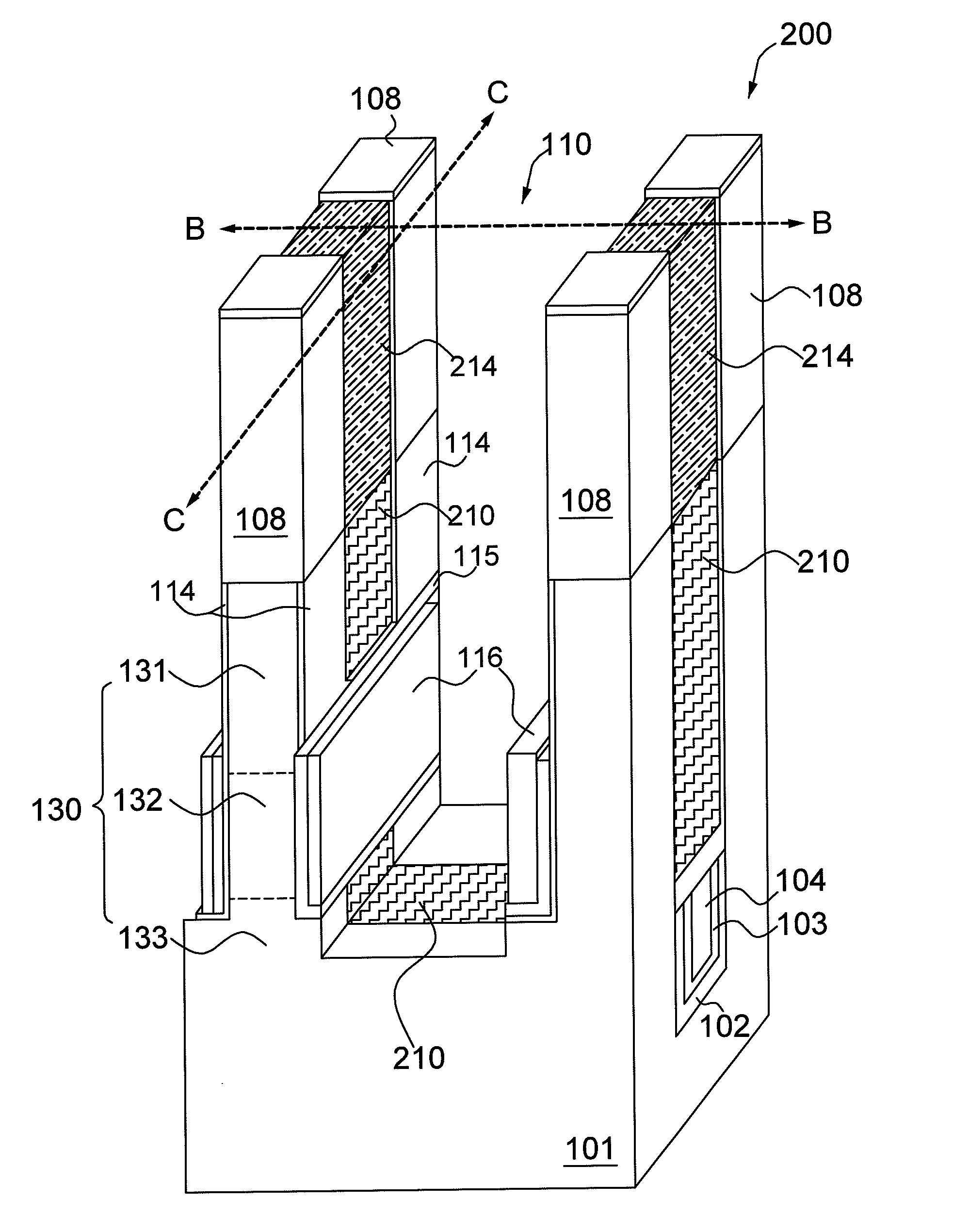
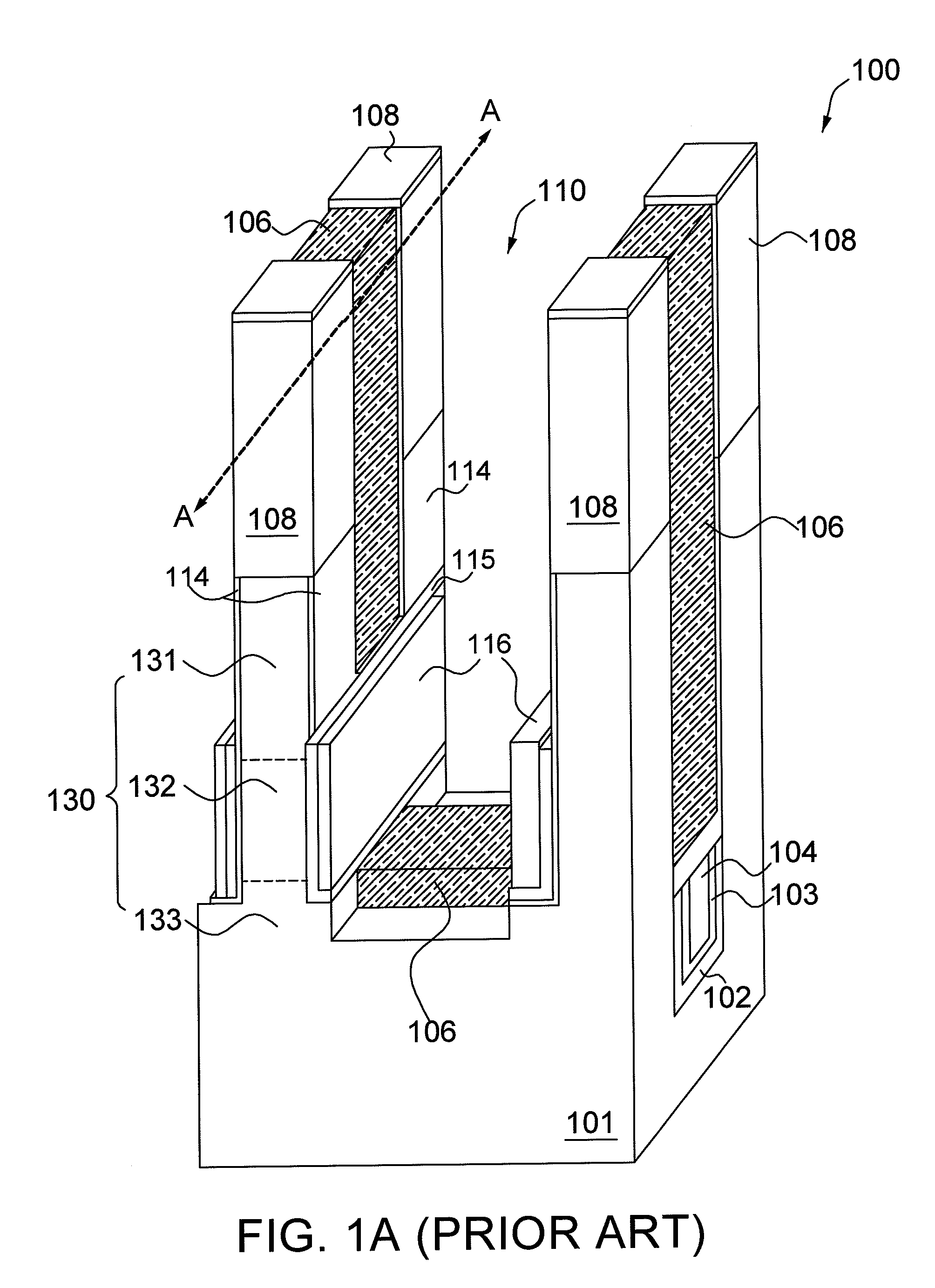
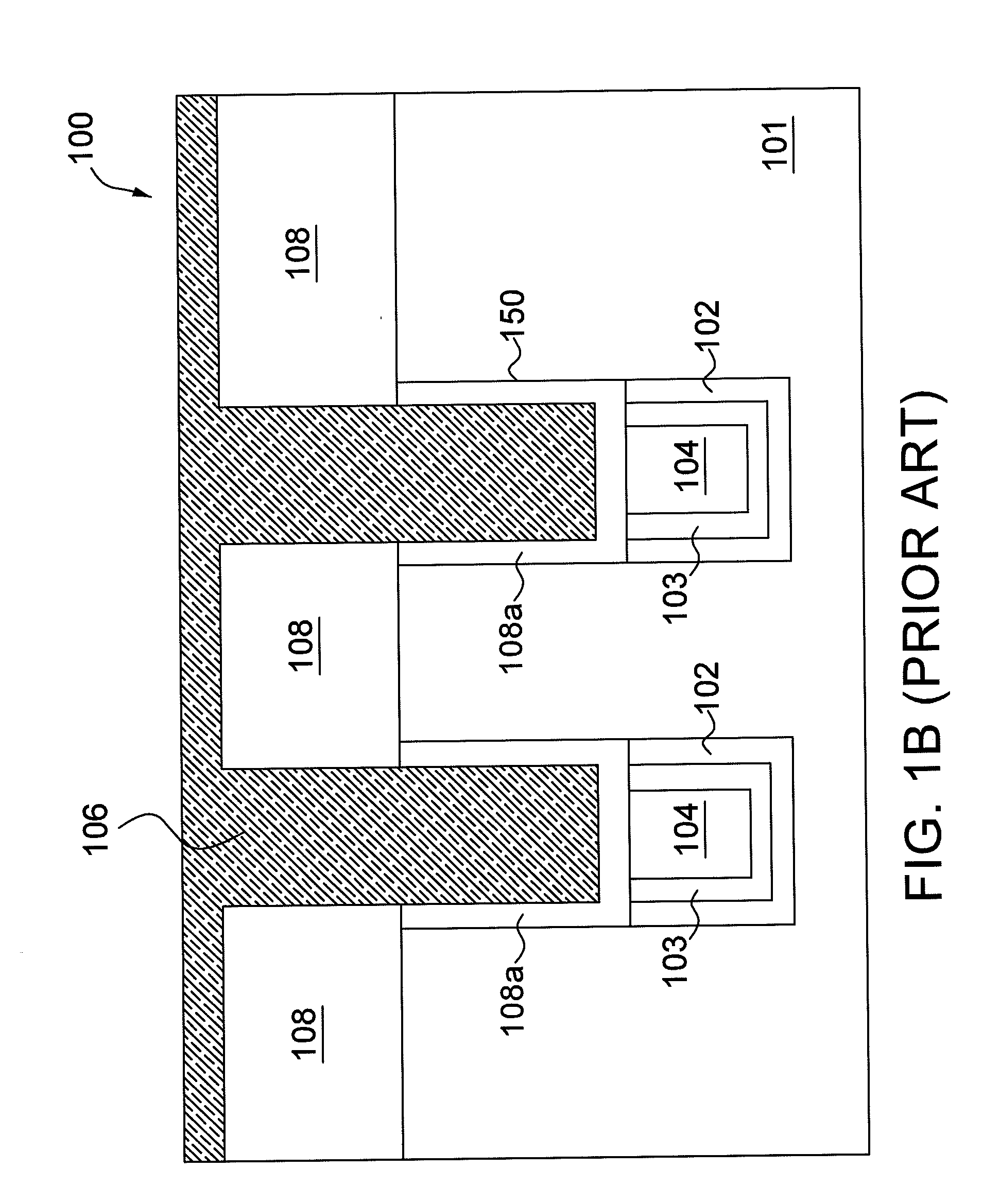
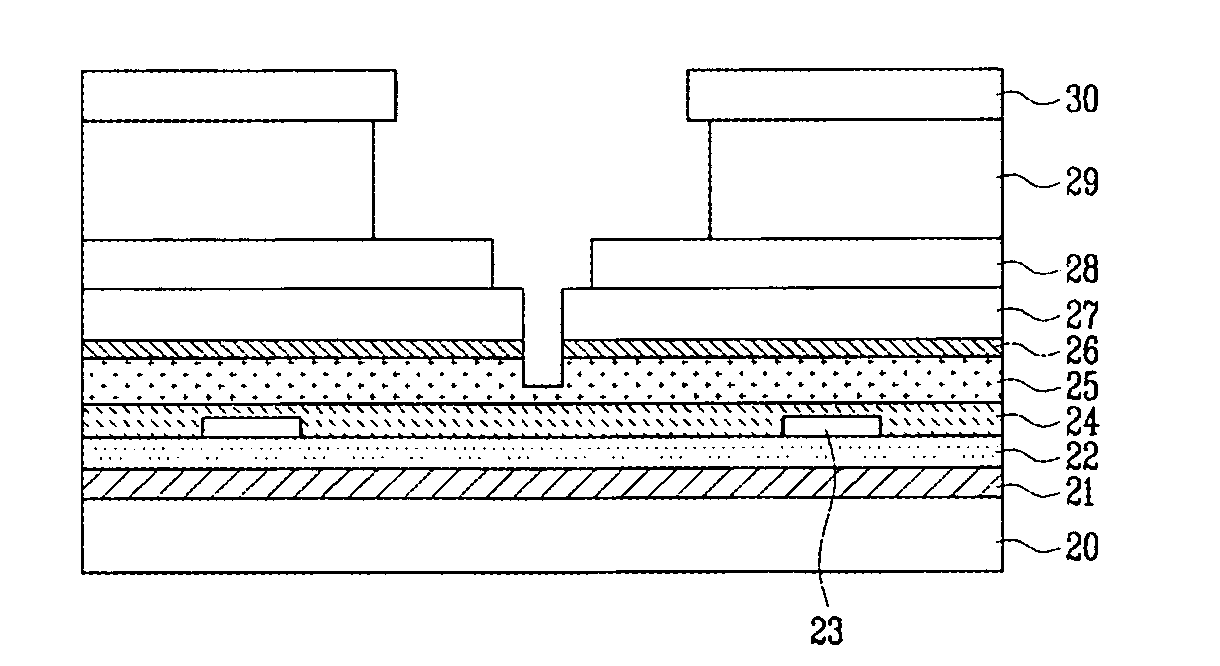

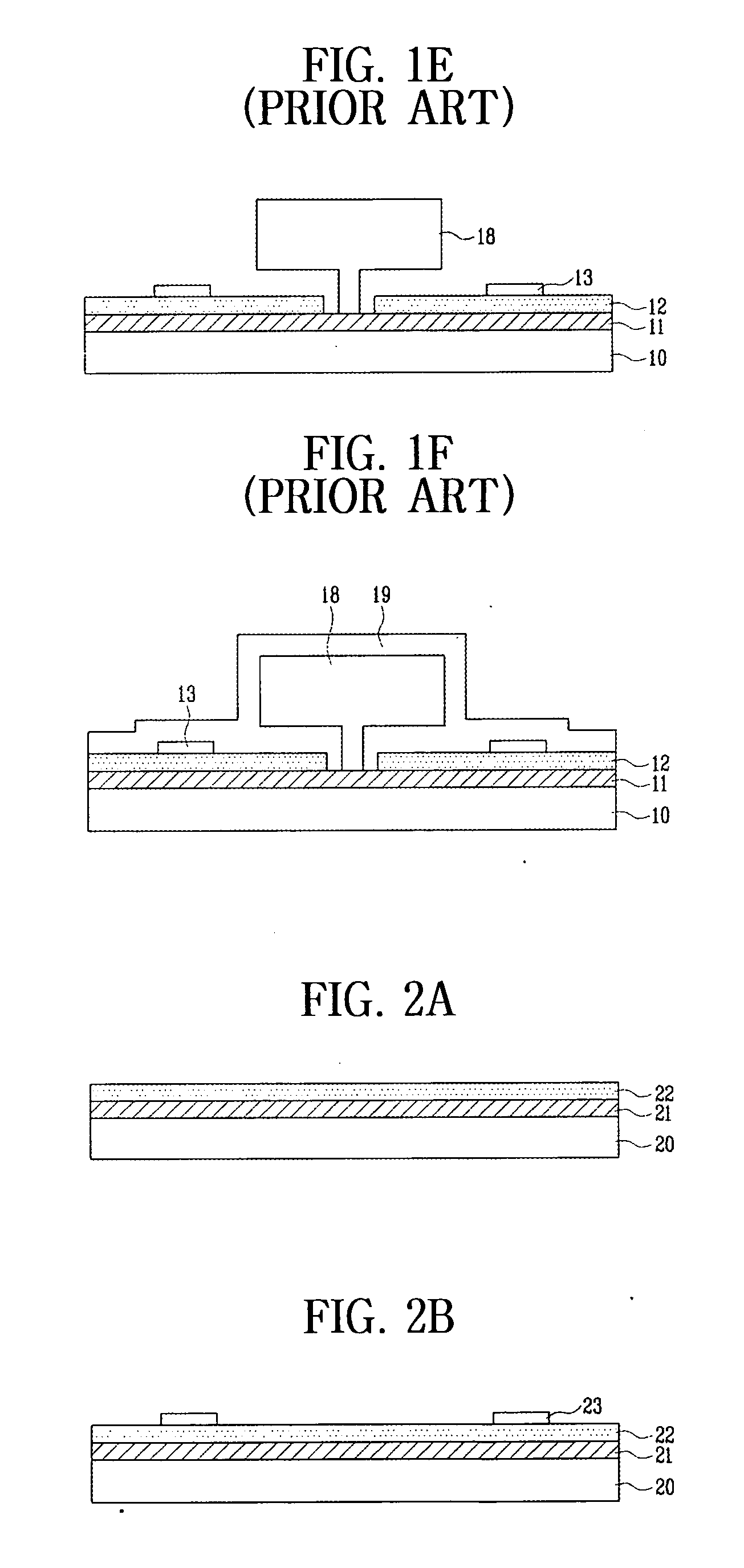

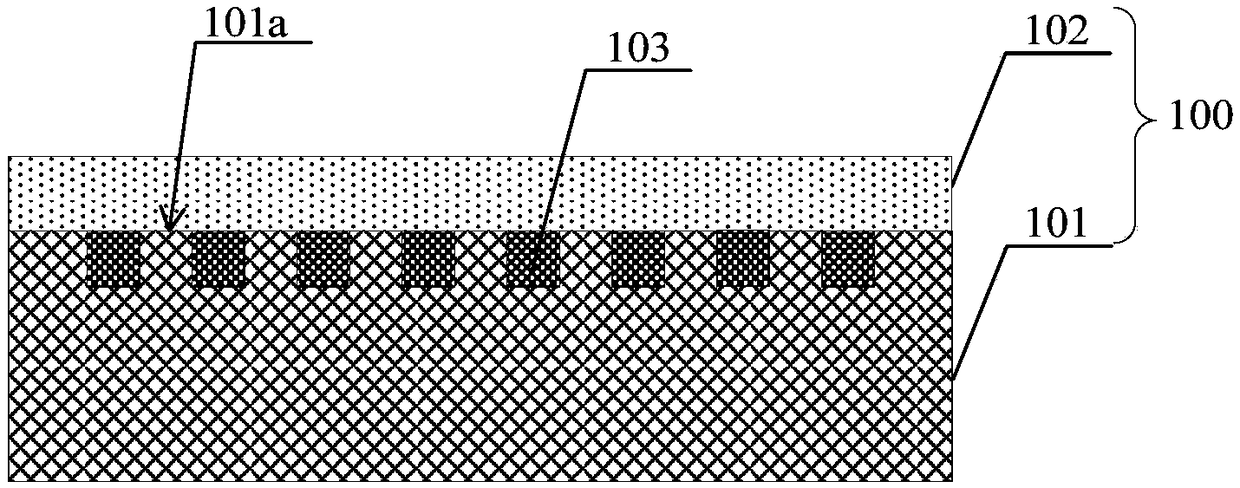

![Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method](https://images-eureka.patsnap.com/patent_img_release/38585591-87d6-4f06-8e07-ed0eac7d2896/HDA0000721352810000011.PNG)
![Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method](https://images-eureka.patsnap.com/patent_img_release/38585591-87d6-4f06-8e07-ed0eac7d2896/HDA0000721352810000021.PNG)
![Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method Etching solution for dislocation display of monocrystal germanium wafer deflecting to crystal orientation [111] and etching method](https://images-eureka.patsnap.com/patent_img_release/38585591-87d6-4f06-8e07-ed0eac7d2896/HDA0000721352810000022.PNG)